| 仕様 |
線源: Cu (波長: 1.54 Å)
測定法: 透過法, 微小角入射(GI)法
二次元検出器: PILATUS 100k(Dectris社)
アタッチメント・特殊測定装置: GI-XRD測定用ゴニオステージ、
加熱・冷却ステージ(XRD測定と同期)、高温吹付装置、
回転ゴニオステージ、多連装ホルダ、剪断ステージ、
電場印加装置、音波浮遊装置
検出範囲: 0.08˚ ≤ 2θ ≤ 65˚(0.14
nm ≤ d ≤ 100 nm)
測定温度範囲: –196 ˚C ~ 350 ˚C(加熱・冷却ステージ: Linkam社;HFSX350-GI)
–190 ˚C ~400 ˚C(加熱・冷却ステージ: INSTEC社HTC402)
室温~800 ˚C (高温吹付装置)
室温~200 ˚C (GIステージ)
連続測定試料数: 25(多連装ホルダ使用時)
測定可能なサンプル: 有機結晶・無機結晶・高分子・液晶・ゲル・
界面活性剤など(粉末・薄膜・フィルム・溶液や分散液などの液体も可)
測定サンプル量: 粉末の場合は1 mgから可、その他は応相談
解析ソフトウエア: 2DP、SmartLab Studio II、PDXL |
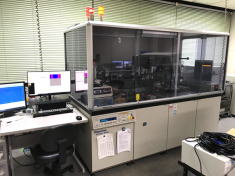 |
近年、ナノテクノロジーを駆使して、高分子材料やタンパク質、液晶、界面活性剤、半導体材料などの様々な分野で新しい物質が作られています。0.1〜100 nmの周期構造を有するこれらの物質を評価する手法として、X線散乱/回折法が知られています。当部門で管理するX線散乱/回折測定装置(NANO-Viewer)は、これらの物質の原子レベル(0.2〜1 nm)から分子レベル(1〜100 nm)までの構造を評価できる装置です。
本装置の特徴として、(1)二次元検出器を用いた配向サンプルの構造解析、(2)高温(800 ℃)から低温(–200 ℃)までの温度可変測定、(3)薄膜サンプルの微小角入射X線回折(GI-XRD)測定、(4)サンプルステージ周辺への大型装置の導入によるin-situ測定、(5)自動ステージと多連装ホルダを用いた複数試料の連続測定が挙げられます。得られたデータは、解析ソフトウエア(2DP、SmartLab Studio II)により精密解析が可能です。
これらの測定により、様々な材料のミクロからマクロスコピックな構造を明らかにします。 |
|
|