電子顕微鏡・試料作製
電界放射型透過型電子顕微鏡 200kV JEM-2010F (日本電子)
■用途
透過像観察(TEM)、高分解能観察、明視野(BF)・暗視野(DF)像観察、電子回折・制限視野回折
ナノビーム電子回折、収束電子回折、走査透過像(STEM)、高分解能明視野(BF)、暗視野(ADF)
高角度環状暗視野(HAADF)観察(準備中)、X線分析(EDS) 点分析・線分析、面分析
マッピング、電子エネルギー損失分析(EELS)、画像取込(Digital/Analog)、画像処理
■仕様
| 電子銃 | 熱電界放射型 ZrO/W(100) ショットキー方式 |  |
| 加速電圧 | 200kV (200kV 未満は不可) | |
| ホルダー | サイドエントリー方式 1軸傾斜/2軸傾斜/Be_2軸傾斜 |
|
| ポールピース | URP22(超高分解能仕様) | |
| 球面収差係数Cs | 0.5mm | |
| 色収差係数Cc | 1.1mm | |
| 点分解能 | 0.19nm | |
| ビーム径 | 2-5nm(TEM mode) 0.5-2.4nm (probe mode) |
|
| 倍率 | x50 ~ x1,500,000 | |
| 最大傾斜角 | ±17°(実用値) | |
| 背圧 | 電子銃 <1×10-7 Pa 鏡筒 <1×10-5 Pa |
■備考
【付属機器】
JEOL社製 透過走査像観察装置(STEM) 【ASID EM-34010BU】
JEOL社製 YAP:Ce HAADF検出器 【EM-24010】
Gatan社製 BF/DF検出器* 【BF/DFModel 805】
Gatan社製 デジスキャン 【DigiscanModel 688】
Gatan社製 マルチスキャンカメラ* 【MSC Model 794】
EDAX社製 エネルギー分散型X線分析装置* 【Genesis】
電界放射型球面電子収差補正電子顕微鏡 R005 (日本電子)
■用途
・超高分解能観察透過像観察(TEM)
明視野(BF)、暗視野(DF)、電子回折、制限視野回折、ナノビーム電子回折、収束電子回折
・超高分解能走査透過像(STEM)
明視野(BF)、暗視野(HAADF)
・画像取込 (Digital/Analog)、画像処理
■仕様
| 電子銃 | 冷陰極電界放出型電子銃(CFEG) |  |
| 加速電圧 | 300kV、200kV、80kV | |
| ホルダー | サイドエントリー方式、最大傾斜角X/Y±25° Quick1軸/強化1軸/強化2軸/加熱2軸/ Be_2軸傾斜/他 |
|
| ポールピース | FHP(超高分解能仕様) | |
| 球面収差係数Cs | -0.1~0.1mm | |
| 色収差係数Cc | 1.5mm | |
| 分解能 | 0.1nm(TEM粒子)、0.1nm(STEM) | |
| 最小ビーム径 | 0.1nm | |
| 倍率 | x2K~x1.5M(TEM)、 x20K~x150M(STEM) |
|
| 真空度 | 電子銃 ≦10-9 Paオーダー 鏡筒 ≦10-6 Paオーダー |
■備考
【付属機器】
Gatan社製 デジスキャン【DigiScanⅡ788】
Gatan社製 エネルギー損失分光分析装置【GIF 865】
Gatan社製 ウルトラスキャンカメラ【USC Model 894】
日本電子製 高感度CCDカメラ【EM-CCD】*PC故障中、修理待ち中
日本電子製 ABF絞り装置
日本電子製 低加速観察装置
日本電子製 ピエゾ駆動試料移動装置
透過型電子顕微鏡 120kV H-7650 Zero.A (日立製作所)
■用途
低加速電圧・高分解能観察、デジタル撮影、電子線トモグラフィ(3D-TEM)
■仕様
| 電子銃 | 熱電子放出型 W-ヘアピンフィラメント | 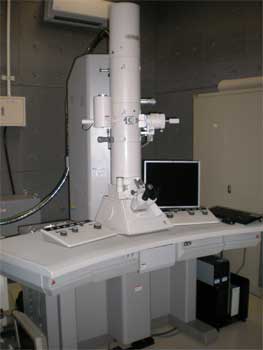 |
| 加速電圧 | 40 ~ 120kV | |
| ホルダー | サイドエントリー方式 1軸傾斜 | |
| 分解能 | 0.204nm(格子像) | |
| スポットサイズ | 0.8-4um(HCモード) 0.6-2um(HRモード) |
|
| 倍率 | 700 ~ ×200,000(HCモード) ×4,000 ~ ×600,000(HRモード) |
|
| 最大傾斜角 | ±60° | |
| CCD画素数 | 1,024 x 1,024 pixel |
■備考
電界放射型走査電子顕微鏡 SU9000 (日立ハイテク)
■用途
インレンズ対物式超高分解能電界放出型走査電子顕微鏡
■仕様
| 電子銃 | 冷陰極電界放出型 |  |
| 加速電圧 | 0.5kV ~ 30kV | |
| 二次電子分解能 | 0.4nm(ACC 30kV, 倍率800k) 1.2nm(ACC 1kV, 倍率250k) |
|
| STEM分解能 | 0.34nm(ACC 30kV) | |
| 検出器 | 二次電子検出器(SE/BSE) 低角度反射電子検出器 BF/DF Duo-STEM検出器 エネルギー分散形X線検出器 |
■備考
【付属機器】
AMETEK社製 エネルギー分散型X線分析装置
シリコンドリフト検出器(分解能129eV)
アナライザ GENESIS(AMETEK EDAX)
アクティブ磁場キャンセラ
除震台
電界放射型走査電子顕微鏡 JSM-7500F (日本電子)
■用途
高分解能観察、2次電子像観察、低加速観察、反射電子像観察、デジタル画像取り込み
■仕様
| 電子銃 | 冷陰極電界放出型 |  |
| 加速電圧 | 0.5 ~ 30kV | |
| 二次電子分解能 | 1.0nm(加速電圧 15kV) | |
| 倍率 | ×25 ~ ×1,000,000 | |
| 検出器 | 二次電子検出器・反射電子検出器 | |
| 作動距離(WD) | 1.5mm ~ 25mm | |
| 試料ステージ | 26mmφ |
■備考
装置保護のため、観察に供する前に試料の予備排気が必要です。前日までに観察試料を持参し、事前処理及び予備排気を行ってください。
卓上走査電子顕微鏡 JCM-7000 (日本電子)
■用途
2次電子像観察、反射電子像観察、低真空観察
■仕様
| 電子銃 | タングステンフィラメント |  |
| 加速電圧 | 5kV, 10kV, 15kV (3段階) | |
| 倍率 | ×10 ~ ×100,000 | |
| 検出器 | 二次電子検出器・反射電子検出器 | |
| 最大試料サイズ | 32mmφ(試料ホルダ使用) 80mmφ , 50mm H(試料ホルダなし) |
■備考
集束イオンビーム試料加工装置【FIB】 FB-2100(日立ハイテク)
■用途
走査イオン顕微鏡(SIM)像観察
極微細加工
■仕様
| 電子銃 | Gaイオン銃 |  |
| 加速電圧 | 10 ~ 40kV | |
| プローブ径 | 8-1000nm | |
| プローブ電流 | 30nA | |
| 像分解能 | 6nA | |
| 検出器 | 二次電子検出器 | |
| 倍率 | ×700 〜 ×90,000 | |
| 試料ホルダ | ステージホルダー (5mm × 9mm × 2.4mmt) |
|
| デポ源 | タングステン |
■備考
マイクロサンプリング機構搭載
バルクステージ上の加工可能領域(2mm × 7mm)
デュアルビーム顕微鏡【FIB-SEM】 Scios(日本エフイー・アイ)
■用途
ニ次電子像観察、反射電子像観察、EDS、EBSD、極微細加工、3次元解析
■仕様
| 電子光学系 | 電子線源:FEG電子銃 加速電圧:350V ~ 30kV 分解能 :1nm(加速電圧 30kV) 電流量 :1pA ~ 400nA |
 |
| イオン光学系 | イオン源:Ga液体金属イオン 加速電圧:500V ~ 30kV 分解能 :3nm(加速電圧 30kV) 電流量 :0.6pA ~ 65nA その他 :15個の孔の可動絞り |
|
| 検出器 | 二次電子検出器、反射電子検出器 |
■備考
【付属機器】
EDS、EBSD (AMETEK)
Ptデポジション
ソフトウェア:
Auto Alice&View G3
Amira 3次元再構築
ifast Developer’s Kit
ウルトラミクロトーム・ウルトラクライオトーム【UMT・Cryo UMT】 (ライカ)
■用途
電子顕微鏡による観察のための高品質な断面作製及び切片(超薄切片)の切り出し
■仕様
| 切削方式:重力ストロークシステム 付属装置:クライオユニット Leica EMFCS 静電気除去装置 DiATOME STATIC LINE II |
  |
■備考
クロスセクションポリッシャー【CP】 SM-09010CP・SM-09020CP (日本電子)
■用途
電子顕微鏡などの試料作製。Arイオンビームで試料の断面加工を行う。
■仕様
| イオン加速電圧 | 2 ~ 6kV |  |
| イオンビーム径 | 500μm(半値幅) | |
| ミリングスピード | 200μm/2H (加速電圧:6kV、シリコン換算、エッジ距離:100μm) |
|
| 最大搭載試料サイズ | 幅11mm × 長さ10mm × 厚さ2mm | |
| 試料移動範囲 | X軸:±3mm 、Y軸:±3mm |
■備考
当部門では2台のCPを保有しており、そのうちの1台をセルフユーザーに開放しています。
冷却クロスセクションポリッシャー【CCP】 IB-19520CCP (日本電子)
■用途
電子顕微鏡などの試料作製。Arイオンビームで試料の断面加工を行う。
試料を冷却した状態でのイオンビーム照射が可能。
■仕様
| イオン加速電圧 | 2 ~ 8kV |  |
| イオンビーム径 | 500μm(半値幅) | |
| ミリングスピード | 500μm/2h (加速電圧:8kV、試料:Si、エッジ距離:100μm) |
|
| 最大搭載試料サイズ | 幅11mm × 長さ8mm × 厚さ3mm | |
| 試料移動範囲 | X軸:±6mm、Y軸:±2.5mm | |
| 試料ステージ冷却温度設定範囲 | 0℃ ~ -120℃ | |
| 冷媒 | 液体窒素 | |
| 冷却保持時間 | 8時間以上(冷却タンク容量:1L) |
■備考
温度調節機能によって調整されるのは試料ステージの温度です。正確な試料温度、ビーム照射点の温度は保証されません。
イオンスライサー EM-09100IS (日本電子)
■用途
電子顕微鏡などの試料作製。Arイオンビームで試料のTEM用薄膜加工を行う。
■仕様
| イオン加速電圧 | 1 ~ 8kV |  |
| イオンビーム径 | 500μm(半値幅) | |
| 傾斜角 | 最大±6°(0.1°ステップ) | |
| エッチングレート | 5μm/min (加速電圧8kV、シリコン換算) |
|
| 試料サイズ | 幅0.5mm × 長さ2.8mm × 厚さ0.1mm |
■備考
低角度イオンポリッシングシステム Model 691 (Gatan)
■用途
TEM試料の低角度高速イオン研磨装置
■仕様
| イオン源 | Arイオン ペニング型イオン銃 | 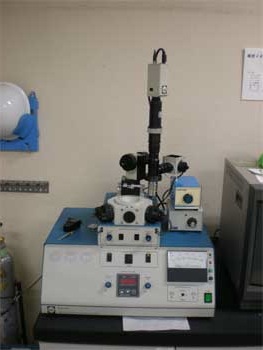 |
| イオンエネルギー | 1 ~ 6keV | |
| ビーム径 | FWHM 350um (5keV) | |
| イオン電流密度 | 10mA/cm2/銃 | |
| ビーム照射角 | 0° ~ ±10°(±0.2°) | |
| 真空系 | ダイヤフラムポンプ ターボ分子ポンプ |
|
| 背圧 | < 1×10-6 torr | |
| モニタリング | カラーCCDカメラシステム | |
| 倍率 | 550 ~ 2600倍(20インチモニタ) |
■備考
超音波ディスクカッター Model 601 (Gatan)
■用途
研削剤を超音波振動させて2.3/3mmφのディスク状、または4mmx5mmの矩形状に打ち抜きTEM試料とする
■仕様
| 振動子 | PZT圧電結晶 |  |
| 周波数 | 28kHz | |
| ブレード | 3mmΦ、2.3mmΦ、4mmx5mm | |
| 研削剤 | #320ボロンカーバイド | |
| 切削深さ | 最大5mm |
■備考
ディンプルグラインダー Model 656 (Gatan)
■用途
イオンミリング法によるTEM試料の最終機械研磨
試料ディスクの縁を厚くしたまま凹面上に研削、鏡面研磨して中心付近のみを5~20ミクロン程度に薄片化する
イオンミリングの仕上がりの向上、ミリング時間の大幅な削減が可能
■仕様
| 初期試料厚さ | 100um以下 |  |
| 最小加工厚さ | 5 ~ 20um(試料に依存) | |
| 試料台回転速度 | 10rpm | |
| 厚さ制御 | ディジタル/アナログマイクロメータ (精度1um) 実例 Si 5 ~ 10nm 酸化物(MgO SrTiO3)10 ~ 20nm |
|
| センタリング精度 | ±10um | |
| 荷重 | 0-40g | |
| 研削工具 | 球面(真鍮/SUS)15mφ 平面(真鍮)15mφ |
|
| 研削剤 | 2 ~ 4umダイヤモンドペースト | |
| 研磨工具 | フェルト | |
| 研磨剤 | 50nmアルミナスラリー | |
| 試料観察 | x40光学顕微鏡 反射光/透過光 |
■備考
真空蒸着装置 JEE-420T (日本電子)
■用途
電子顕微鏡などでの分析・高分解能観察に適したカーボン膜、各種金属蒸着膜の作製、非導電性材料への導電膜の作製、シャドーイングなど
※電子顕微鏡試料作製に特化した装置です。一般的な製膜装置としての機能は有しておりません。
蒸着源は炭素のみ用意しております。他の蒸着源は利用される方にて御用意願います。
■仕様
| 到達圧力 | 1×10-4 Pa 以下 |  |
| ベルジャ | 250T × φ250mm ガラス製 | |
| 蒸着用電極 | 2組 | |
| ヒーター用電極 | AC10V、50A | |
| 真空系 | ロータリーポンプ 100L/min ターボ分子ポンプ 230L/s 空冷 |
■備考
マグネトロンスパッタコーター E-1030 (日立製作所)
■用途
非導電性のSEM試料を,Pt-Pdで被覆し導電性を付与する

■備考
カーボンコーター VC-100W (真空デバイス)
■用途
試料表面に導電性付与や保護膜としてカーボンを被覆する

■備考
