X線分析装置
粉末X線回折計 X’Pert-MPD-OES (Philips(PANalytical))
■用途
粉末・薄膜X線回折法、格子定数測定等、加熱・冷却測定
■仕様
| ターゲット | Cu | 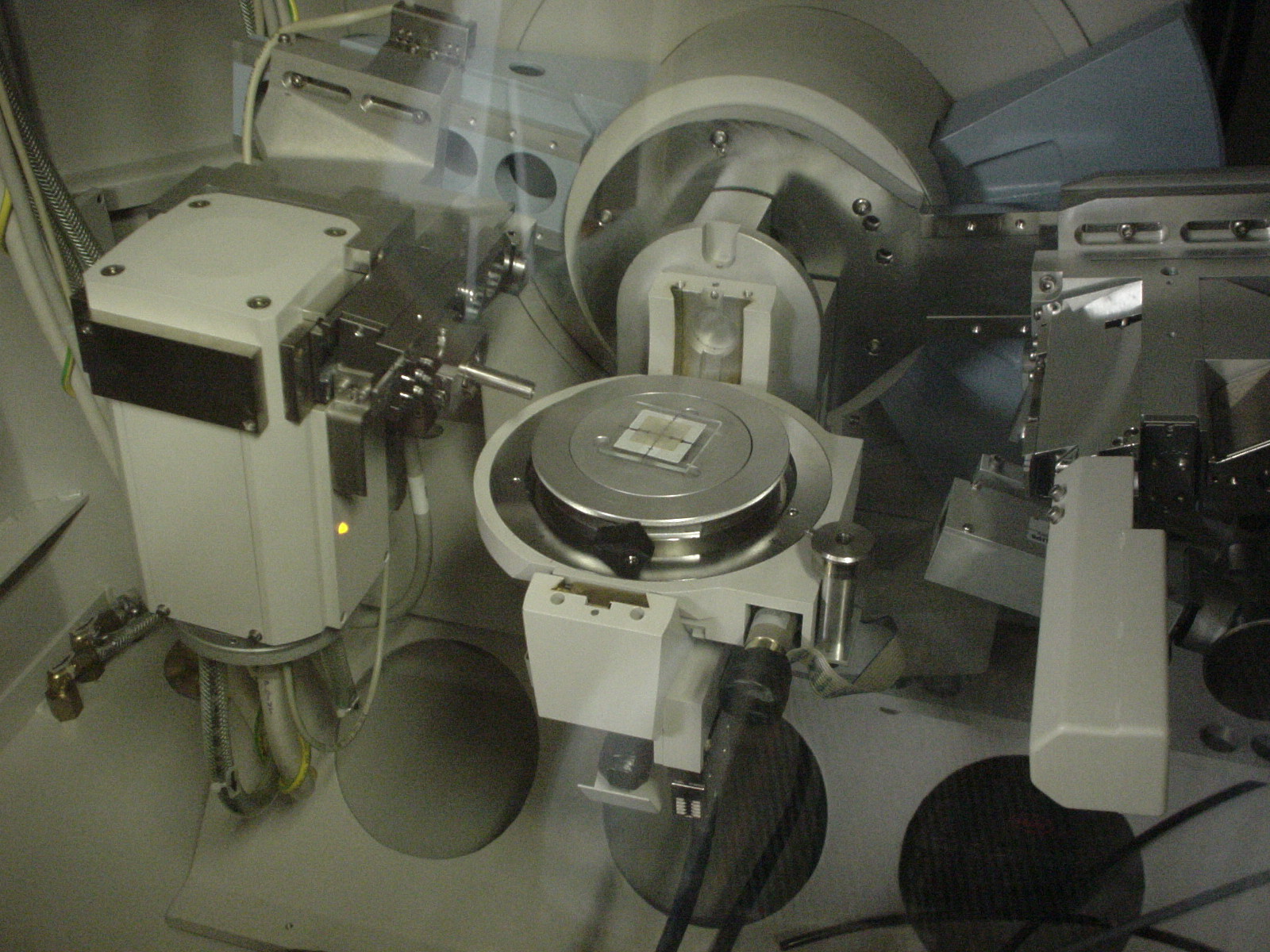 |
| 出力 | 45kV-40mA(特殊条件) | |
| ゴニオメーター | 2Theta/Omega型(試料水平型ゴニオメーター) | |
| 光学系(全体) | 1.Bragg-Brentano擬集中光学系—Line Focus 2.平行光学系(薄膜光学系)—Line Focus |
|
| 入射光学系 | 1.Bragg-Brentano擬集中光学系用:ソーラースリット(0.04deg)/発散スリット/マスク | |
| 受光光学系 ダブルディテクタ |
1.集中光学系用:散乱防止スリット/自動受光スリット/ソーラースリット/湾曲結晶モノクロメータ 2.平行光学系用:平行平板コリメータ/平板結晶モノクロメータ |
|
| 検出器 | 封入型比例計数管 | |
| オプション | 中低温チャンバー TTK450(-193 ~ 300℃) Anton Paar社製 |
■備考
薄膜材料結晶性解析用X線回折装置 X’Pert-Pro-MRD (Philips(PANalytical))
■用途
薄膜の逆格子空間マッピング(2Theta/Omega-Omega,2Theta/Omega-Chi)
薄膜の超高速逆格子空間マッピング(2Theta-Omega),高分解能ロッキングカーブ,
In-Plane測定,極点図形測定,微細試料の超高速粉末X線回折測定 など
■仕様
| ターゲット | Cu | 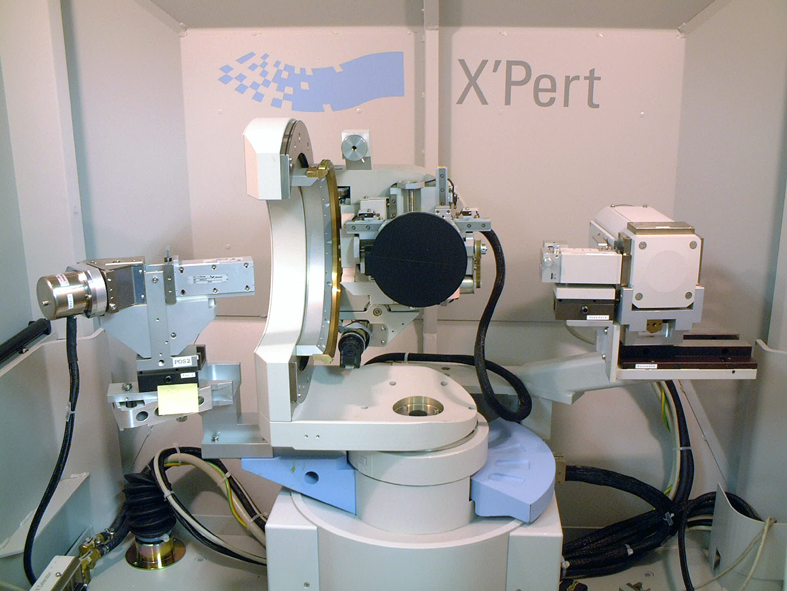 |
| 出力 | 45kV-40mA | |
| ゴニオメーター | 2Theta/Omega/Chi/Phi/X/Y/Z型 | |
| 光学系(全体) | 1.Bragg-Brentano疑似集中光学系(スリットのみ)—Line Focus 2.平行光学系(モノクロ/ミラー使用)—Line Focus 3.疑似平行(ピンホール)光学系(レンズ使用)—Point Focus |
|
| 入射光学系 | 1.X線キャピラリーレンズ(発散角0.3deg)/ミラー(発散角0.03deg)/2結晶Ge(220)ハイブリッドモノクロメータ/オートアッテネータ/プログラマブル発散スリット/ソーラースリット(0.04rad)/発散スリット/マスク 2.ピンホール疑似平行光学系用:Primary Beam Channel/ピンホールコリメーター |
|
| 受光光学系 | 平行平板コリメータ(0.09deg,0.27deg)/グラファイトモノクロメータ/トリプルアクシスダブルディテクタ/ロッキングカーブディテクタ | |
| 検出器 | 封入型比例計数管、1次元検出器 X’Celerator |
■備考
低角度測定、薄膜X線法を使用している方で、極点図形測定装置(OEC)では分解能が不足する場合はご相談下さい。
微小部X線回折装置 D8 DISCOVER μHR (Bruker AXS)
■用途
薄膜と粉末のX線回折測定
1.2次元検出器
微小領域での相同定、極点図測定、残留応力測定、広域マッピング (2Theta-Psi)、
試料面マッピング (X,Y)、In-Plane測定、加熱測定
2.シンチレーションカウンタ
X線反射率測定、In-Plane測定
■仕様
| ターゲット | Cu | 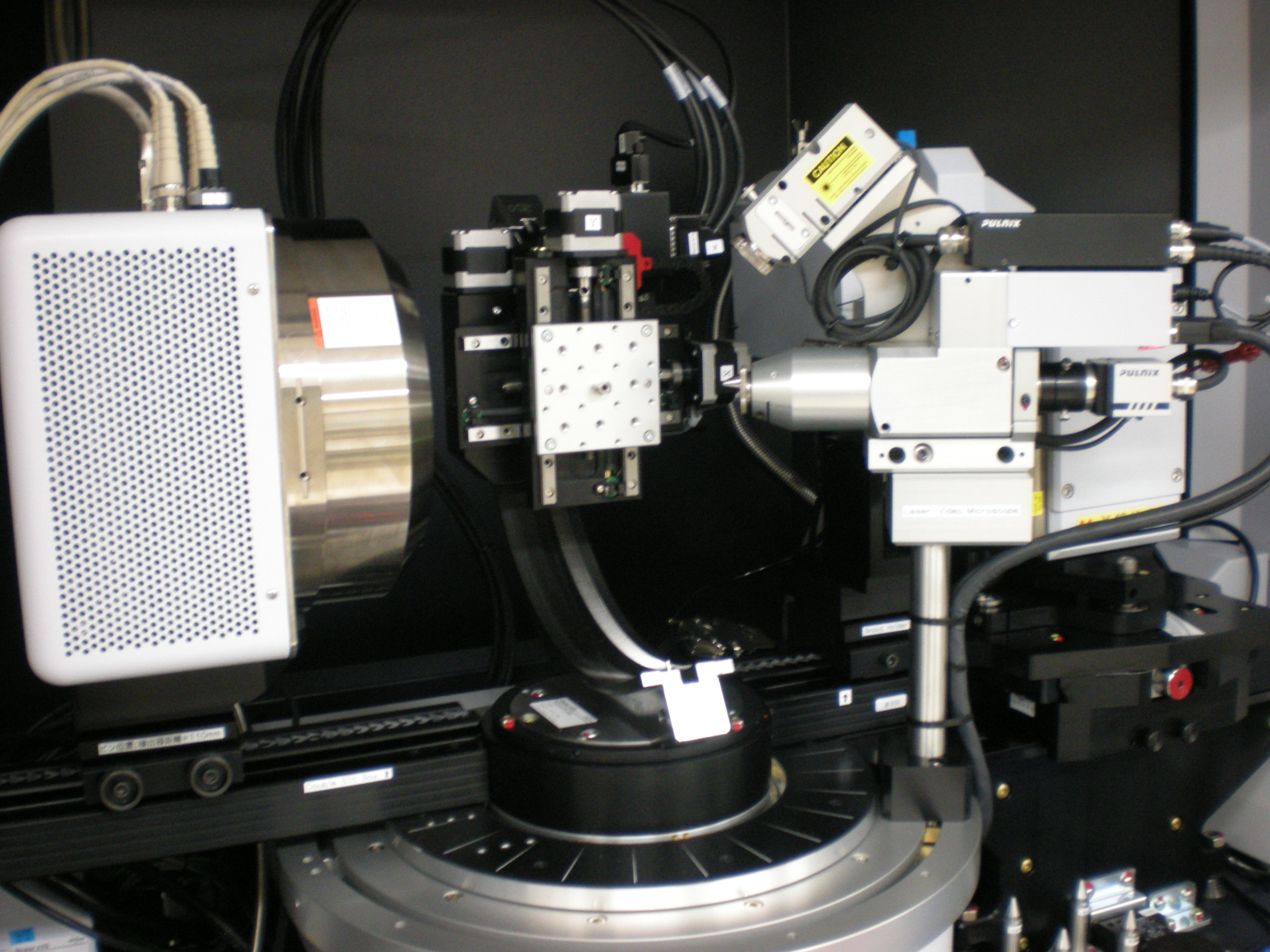 |
| 出力 | 50 kV – 22 mA | |
| ゴニオメーター | 2Theta, omega | |
| 測定ステージ | 多軸ステージ (X, Y, Z, Phi, Psi) 高温試料ステージ (室温 ~900℃) Anton Paar 社製 DHS-900 |
|
| CCD搭載 レーザービデオ 顕微システム |
画像取込み最大試料サイズ:8mm角程度 | |
| 光学系 | 入射光学系 二次元多層膜ミラー (発散角 0.04 deg) 金属コリメータ (φ.05, 0.1, 0.3, 0.5, 1 mm) 受光光学系 スリットボックス (シンチレーション使用時) |
|
| 検出器 | 二次元検出器 VANTEC-500 (検出器距離 200 mm、300 mm) シンチレーションカウンタ |
■備考
レーザービデオで高さ調整を行います。レーザーを吸収、透過するサンプルは高さ調整が難しいため、測定できないことがあります。
X線照射面積が小さいため、試料平均のデータ収集には向きません。
検出器とレーザービデオの位置関係により検出器中心は108°(2θ最大は 123°)までです。
参考
本装置を使用した測定例 (3/16開催 報告会資料)
(報告提供 材料工学専攻 中村・史研究室)(PDF書類 1.5MB)
卓上X線回折計 Mini Flex 600 (リガク)
■用途
粉末X線回折法、格子定数測定等
■仕様
| ターゲット | Cu |  |
| 出力 | 40kV-15mA | |
| ゴニオメーター | 2θ/θ型(半径:150mm) | |
| 光学系(全体) | 集中光学系—Line Focus | |
| 入射光学系 | ソーラースリット(2.5deg)/発散スリット/マスク(高さ制限スリット) | |
| 受光光学系 | ソーラースリット(0.5deg,2.5deg)/散乱スリット/受光スリット | |
| 検出器 | 高速1次元検出器D/teX Ultra2 | |
| オプション | 可変ナイフエッジ、回転試料台、蛍光除去モード、大型試料用ステージ(膜も可) |
■備考
エネルギー分散型蛍光X線分析装置 NEX DE (リガク)
■用途
X線分析(EDX)、膜厚解析(薄膜)
■仕様
| X線管 | 最大出力12W、最大管電圧60kV ターゲット:Ag |
 |
| 検出器 | 半導体検出器:SDD(シリコンドリフトディテクタ) | |
| 測定径 | コリメータ自動交換機構 (1mm、3mm、10mm) |
|
| 試料観察機構 | 装置内蔵カメラ | |
| 1次X線フィルタ | 自動交換:6種類 + オープン | |
| 検出元素 | 大気:Al ~ U ヘリウム:Na ~ U |
|
| 分解能 | 140eV以下 | |
| 試料室寸法 | 305mm(W) × 305mm(D) × 105mm(H) | |
| 試料台 | 15試料交換機構(試料径32mm用) |
